SEM мен AFM: жоғары рұқсатты беттік сипаттаудың тарихы, жұмыс принциптері және салыстырмалы талдауы


SEM және AFM: жоғары рұқсат етілген қабілетпен бетті зерттеу үшін қолданылатын қосымша әдістер.
Талап етілетін ақпарат түріне байланысты материалдарды сипаттау үшін пайдаланылуы мүмкін аналитикалық әдістердің кең ауқымы бар. Жоғары рұқсат етілген қабілетпен зерттеу үшін пайдаланылатын екі әдіс:Атомдық күштік микроскопия (AFM) және сканерден өткізетін электрондық микроскопия (SEM) - сәйкесінше 1 және 2-суреттер. Осы әдістердің әрқайсысы бетінің құрылымын нанометр деңгейіне дейін төмендетеді. Дегенмен, қалыптастыру механизмдері бір-бірінен ерекшеленеді, бұл бетінің құрылысы туралы әртүрлі ақпаратқа әкеледі. SEM және AFM-нің пайда болуы біртіндеп кең таралған аналитикалық зертханаға айналды. Бұл мақалада екі әдісті салыстыруға болады және бетінің өлшемдерінің нақты түрлерімен салыстырылады және осы аналитикалық әдістер табиғатта қосымша болып табылатын ақпаратты береді.
ТАРИХЫ
Алғашқы СЭМ 1938 жылы фон Арденннің электронды айтарлықтай дәрежеде сканерден өткізу үшін сканерлеудің электронды микроскопын (STEM), электронды микроскоптың (TEM) электронды пучкасын растирлеу жолы арқылы құрастырған. 1942 жылы Zworkinet. және т. б. бірінші SEM үлгілерін әзірледі. Бұл конфигурацияда заманауи SEM негізгі принциптері бар. 1965 жылы Кембридж ғылыми құралдары алғашқы коммерциялық жобаны іске қосты. Осы уақыт ішінде бірнеше жақсартулар болды, соның салдарынан 1942 жылғы рұқсат 50 нм-тан 0, 7 нм-ге дейін артқан. Морфологиялық бейнені әзірлеуден басқа, SEM рентген сәулеленуі, бұрын шашыраған электрондар, катодолюминесценция, оже-электрондар және үлгі тогы сияқты композициялық ақпаратты анықтау үшін пайдаланылатын сигналдарды анықтау үшін әзірленген.
АФМ-ды дамыту 1981 жылы IBM Цюрих зерттеулер зертханасында Binnig және Rohrer сканерлеуші туннелирлеу микроскопын (STM) жасау жолымен жүзеге асырылды. Оның асфальт бетіндегі атом торын көруге қабілеттілігін жасаған өнертапқыштары 1986 жылы физика бойынша Нобель сыйлығын алды. STM үш өлшемде субангромды ажыратымдылықты қамтамасыз етсе де, ол өткізгіш және жартылай өткізгіш үлгілермен шектеледі. Бейне изоляторлары, сондай-ақ өткізгіштер ретінде AtomicForce микроскопы (AFM) 1986 жылы жасалды, ал алғашқы коммерциялық АФМ 1989 жылы Digital Instruments арқылы құрылды.
AFM оқшаулағыштар мен өткізгіштерге арналған нанометрдегі және субангстром тік (вертикаль) рұқсатымен үш өлшемді беткі топографияны қамтамасыз етеді. Осы басынан Scanning ProbeMicroscopy (SPM) өрісі пайда болды, ол сейства техникасынан тұрады, ол үлгінің бетіне соқтығысты сканерлеуді қамтиды, ал үлгінің үлгісімен жоғары ажыратымдылықты қалыптастыру үшін өзара әрекеттесуін бақылайды. AFMhas SPM-ның ең жиі қолданылатын формасы болғанымен, үйкеліс, адгезия, икемділік, қаттылық, электр өрістері, магнит өрісі, тасымалдаушы концентрациясы, температура таралуы, кедергінің таралуы және өткізгіштік ерекшеліктері туралы ақпарат беретін көптеген басқа СПМ әдістері жасалды.

1-сурет. AFM ядросының құрамдас диаграммасы TappingModeTM операциясының кері байланыс циклын бейнелейді

2-сурет. Қарапайым емес SEM негізгі компоненттерінің құрылымы
Визуализациялар механизмы
Сканирлеуші электронды микроскопия
SEM тапсырмасы өткізгіш үлгісі мен сүзгілеу арасындағы кернеуді қолдану болып табылады, бұл электронды сәулеленуді алып келеді. Ол вакуумдық ортада 10-4-тен 10-10 Torr-ға дейінгі диапазон аралықтарында болады. Электрондар электронды бағанда электромагниттік линзалар сериясын қолдана отырып, үлгіге жіберіледі. 2-суретте типтік емес СЕМ-нің схемалық көрінісі бейнеленген. Сурет өрісінің рұқсаты мен тереңдігі бір немесе бірнеше конденсатор линзалары мен соңғы зонд обьективімен реттелетін ток пучкасы және түпкілікті өлшеммен анықталады. Линзалар сфералық аберрациацияның, хроматикалық аберрациацияның, дифракцияның және астигматизмнің әсерін барынша азайту үшін пучок құру үшін қолданылады. Электрондар пучка параметрлеріне және үлгінің түріне байланысты бірнеше микрондармен бірнеше нонометрде үлгілермен өзара әрекеттеседі. Электрондар іріктен шығарылады, көбінесе электрондар мен кері қайталама электрондар арқылы шығарылады. Екінші электрондар бетінің морфологиясын зерттеу үшін жиі кездеседі.
Линзалар сфералық аберрациацияның, хроматикалық аберрациацияның, дифракцияның және астигматизмнің әсерін барынша азайту үшін сәуле құруда қолданылады. Электрондар пучок параметрлеріне және үлгінің түріне байланысты бірнеше микрондармен бірнеше нонометрде үлгілермен өзара әрекеттеседі. Электрондар іріктеуден, негізінен кері тежелген электрондардан, сондай-ақ екінші электрондардан шығарылады. Екінші электрондар бетінің морфологиясын зерттеу үшін жиі кездеседі.
Олар пучоктың электрондары мен үлгінің өткізгіштің жолақшасында нашар байланыстырылған электрондардың өзара әрекеттесуінің нәтижесінде пайда болады. Баяу электрондардың кейбір энергиясы үлгілердің бетіне қайталама электрондар түрінде шығу үшін жеткілікті қуат беретін үлгілердегі өткізгіштің электрондарына ауыстырылады. Екінші электрондар электр энергиясының төмен энергиясы (<50 эВ) болып табылады, сондықтан үлгі бетінің алғашқы бірнеше метрінде ғана пайда болатын, шығу және табу үшін жеткілікті қуат бар. Бөлектелген қалдықтар (кері кетіретін электрондар) шашыраған жоғары энергиялық электронды сәулелер, олар бетінен шыққан кезде қосымша электрондарды құра алады. Себебі бұл электрондар қосымша электрондардың үлгісіне еніп кетсе, олар үлгіні интенсивті сәуленің әсерінен әлдеқайда үлкен қашықтықта қалдыруы мүмкін, бұл олардың кеңістіктік үлестірілуін арттырады. Бұл электрондар үлгі бетінен шыққаннан кейін, олар әдетте Everhart-Thornley сцинтилляторлы фотоматериалдары арқылы анықталады. Нәтижесінде алынған SEM кескіні электронды сәулені бетінен өңдеу кезінде әрбір X-ші деректер нүктесінің үлгісі бойынша екінші электронды сәулелену қарқындылығының нәтижесі болып табылады.
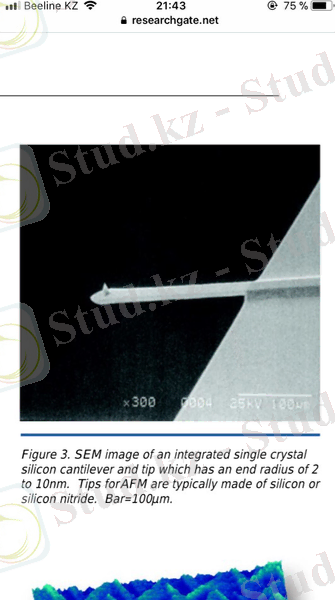
3-сурет. 2-ден 10 нм дейінгі соңғы радиусы бар интегралды монокристаллы конструкторлы SEM кескіні. AFM кеңестері әдетте кремнийден немесе кремний нитридінен жасалған. Бар = 100 мкм.
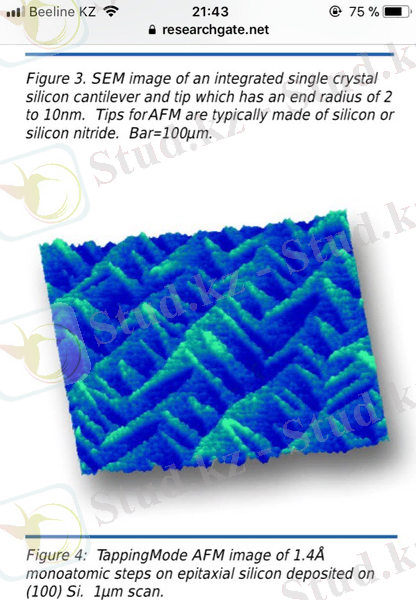
4-сурет. (100) Si-ге орналастырылған эпитаксиалды кремнийдегі 1, 4-моноатомдық қадамдардың TappingMode AFM AFM бейнесін түрту. 1 мкм сканерлеу.
... жалғасы- Іс жүргізу
- Автоматтандыру, Техника
- Алғашқы әскери дайындық
- Астрономия
- Ауыл шаруашылығы
- Банк ісі
- Бизнесті бағалау
- Биология
- Бухгалтерлік іс
- Валеология
- Ветеринария
- География
- Геология, Геофизика, Геодезия
- Дін
- Ет, сүт, шарап өнімдері
- Жалпы тарих
- Жер кадастрі, Жылжымайтын мүлік
- Журналистика
- Информатика
- Кеден ісі
- Маркетинг
- Математика, Геометрия
- Медицина
- Мемлекеттік басқару
- Менеджмент
- Мұнай, Газ
- Мұрағат ісі
- Мәдениеттану
- ОБЖ (Основы безопасности жизнедеятельности)
- Педагогика
- Полиграфия
- Психология
- Салық
- Саясаттану
- Сақтандыру
- Сертификаттау, стандарттау
- Социология, Демография
- Спорт
- Статистика
- Тілтану, Филология
- Тарихи тұлғалар
- Тау-кен ісі
- Транспорт
- Туризм
- Физика
- Философия
- Халықаралық қатынастар
- Химия
- Экология, Қоршаған ортаны қорғау
- Экономика
- Экономикалық география
- Электротехника
- Қазақстан тарихы
- Қаржы
- Құрылыс
- Құқық, Криминалистика
- Әдебиет
- Өнер, музыка
- Өнеркәсіп, Өндіріс
Қазақ тілінде жазылған рефераттар, курстық жұмыстар, дипломдық жұмыстар бойынша біздің қор #1 болып табылады.



Ақпарат
Қосымша
Email: info@stud.kz